东京--(美国商业资讯)--存储器解决方案全球领导者东芝存储器公司今日宣布,公司已开发出全球首款[1]采用硅通孔(TSV)[3]技术的BiCS FLASH™三维(3D)闪存[2],该产品采用三位元(三阶存储单元,TLC)技术。用于开发目的的原型机已于6月发货,产品样品预计将于2017年下半年发布。这一开创性器件的原型机将于8月7-10日在美国加州圣克拉拉举行的2017年闪存峰会上亮相。
这份智能新闻稿包含多媒体内容。完整新闻稿可在以下网址查阅:http://www.businesswire.com/news/home/20170710006538/en/
采用TSV技术制造的器件具有垂直电极和贯穿硅芯片模的通孔实现连接,这种结构在降低功耗的同时实现高速数据输入和输出。其实际性能在之前推出东芝二维NAND闪存[4]时已得到验证。
将48层3D闪存工艺技术和TSV技术相结合,使东芝存储器公司能够成功增加产品编程带宽,同时实现低功耗。单一封装的功率效率[5]是采用引线接合技术制造的同一代BiCS FLASH™闪存功率效率的近两倍[6]。TSV BiCS FLASH™还在单一封装内实现了具有16颗粒堆叠式结构的1TB存储设备。
东芝存储器公司将实现采用TSV技术的BiCS FLASH™的商业化,为包括高端企业级SSD在内的存储器应用提供理想的低延迟、高带宽和高IOPS[7]/watt解决方案。
|
一般规格(原型机) |
||||||||
|
封装类型 |
|
|
NAND Dual x8 BGA-152 |
|||||
|
存储容量 |
|
512 GB |
|
1 TB |
||||
|
栈数: |
|
8 |
16 |
|||||
|
外形尺寸 |
|
|
W |
|
14 mm |
14 mm |
||
|
|
D |
|
18 mm |
18 mm |
||||
|
|
|
H |
|
1.35 mm |
|
1.85 mm |
||
|
接口 |
|
Toggle DDR |
||||||
|
最大接口速度 |
|
|
1066Mbps |
|||||
|
|
||||||||
注:
[1] 数据来源:东芝存储器公司,截至2017年7月11日。
[2] 一种在硅基板上垂直堆叠闪存存储单元的结构,相比平面NAND闪存(存储单元位于硅基板上),其极大地提高了密度。
[3] 硅通孔技术:该技术利用垂直电极和贯穿硅芯片模的通孔在单一封装内实现连接。
[4] “东芝研发出全球首款搭载TSV技术的16颗粒堆叠式NAND闪存”
http://toshiba.semicon-storage.com/ap-en/company/news/news-topics/2015/08/memory-20150806-1.html
[5] 每个功率单位的数据传输速率。(MB/s/W)
[6] 与东芝存储器公司现有产品相比。
[7] 每秒输入输出:每秒钟通过I/O端口处理的数据输入和输出量。数值越大,性能越好。
原文版本可在businesswire.com上查阅:http://www.businesswire.com/news/home/20170710006538/en/
免责声明:本公告之原文版本乃官方授权版本。译文仅供方便了解之用,烦请参照原文,原文版本乃唯一具法律效力之版本。
联系方式:
东芝存储器公司
Kota Yamaji, +81-3-3457-3473
商业规划部
semicon-NR-mailbox@ml.toshiba.co.jp
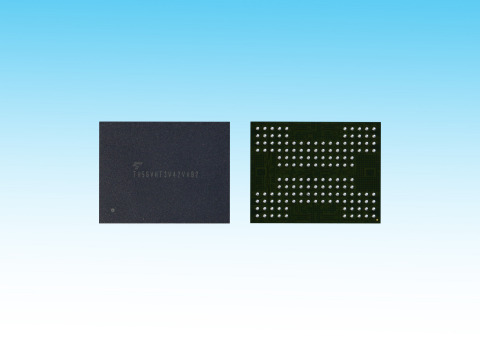
全球首款搭载TSV技术的三维闪存(照片:美国商业资讯)





